DAG810 : 6台(セミオート)
GP-200:1台(CMPセミオート)~8インチ
GP-300:1台(CMPセミオート)~12インチ
高トルクBG機で剛性材にも対応
可能サイズ : ~12インチ
シリコンウェハ
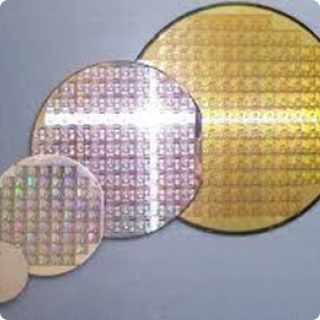
○対応サイズ
Chip単体~φ300mm
□210×210以内
鏡面
(ケミカルポリッシュ)
ポリグラインド
(#8000相当)
厚みばらつき±3um
セラミック基板
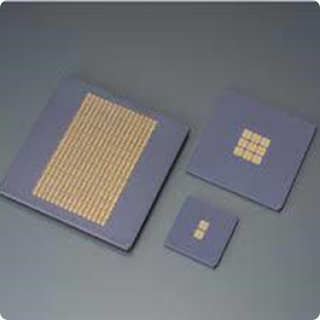
○対応サイズ
Chip単体~φ300mm
□210×210以内
表面仕上げ
(#360)
厚みばらつき±3um
SiC/サファイア


○対応サイズ
Chip単体~φ300mm
□210×210以内
(#1400 #2000)
厚みばらつき±3um
GaN/異種接合品/SUS板/樹脂 など
ご相談ください
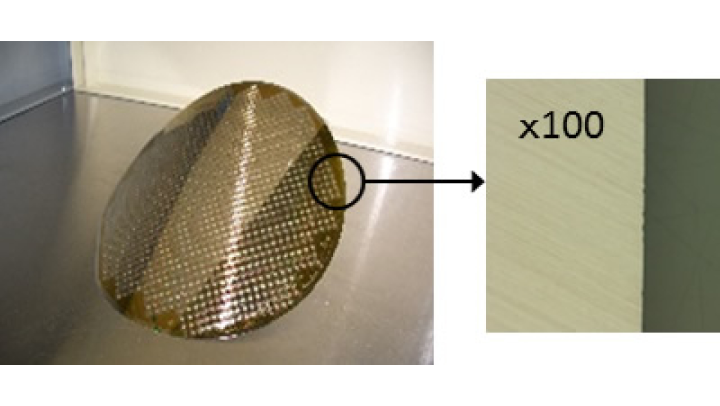
シリコンウエハの薄型
周辺部にダメージが無く研削/研磨
仕上げ厚み0.06mmt量産品(写真)
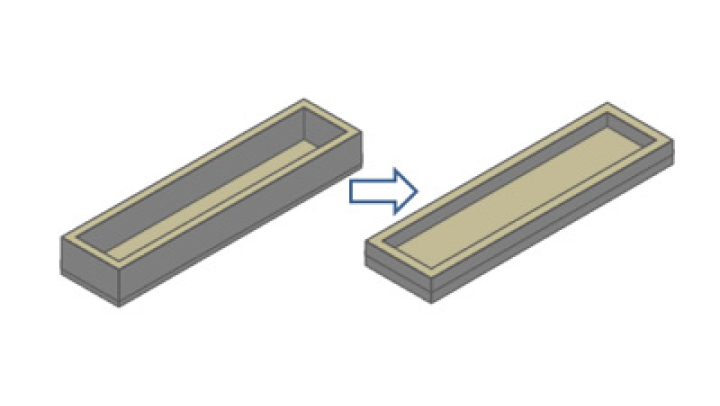
積層セラミック
凹凸のあるセラミックを表裏研削
中空の壁を平坦に研削 ばらつきを無くす
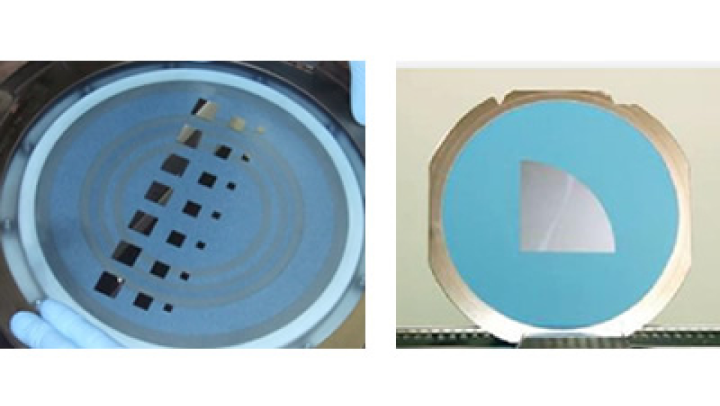
異型のBG/CMP
Chip単体(左)/分割ウェハ(右)を加工
Chip単体:数量一個・大きさ□1.0mmからでも対応
分割ウェハ:分割して厚み違いを作製
*割れたウェハの救済も対応
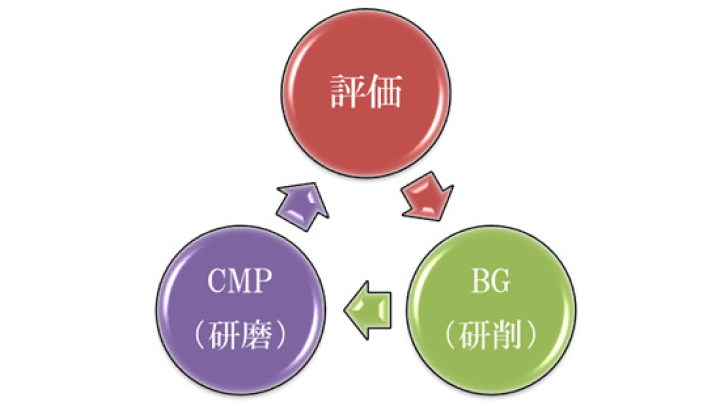
再BG/CMP
研磨後、再研磨が必要と判断した場合再度研磨

貼り合わせウエハのBG
貼り合わせウエハのSiのみ研削

SiCのBG
SiCを30μmに研削